07 July 2025
新規窒化物半導体のヘテロ接合における電子散乱機構を解明 ~GaN-HEMTの性能向上による次世代高周波通信技術の進展に道筋~
住友電気工業株式会社(本社:大阪市中央区、社長:井上 治、以下「当社」)は国立大学法人東京大学(所在地:文京区、総長:藤井輝夫、以下「東京大学」)前田拓也講師ら研究グループとの共同研究を通じて、窒化ガリウムトランジスタ(以下「GaN-HEMT」)の次世代バリア層材料として期待されている窒化スカンジウムアルミニウム(ScAlN)と窒化ガリウム(GaN)のヘテロ接合*1における二次元電子ガスの散乱機構を解明しました。
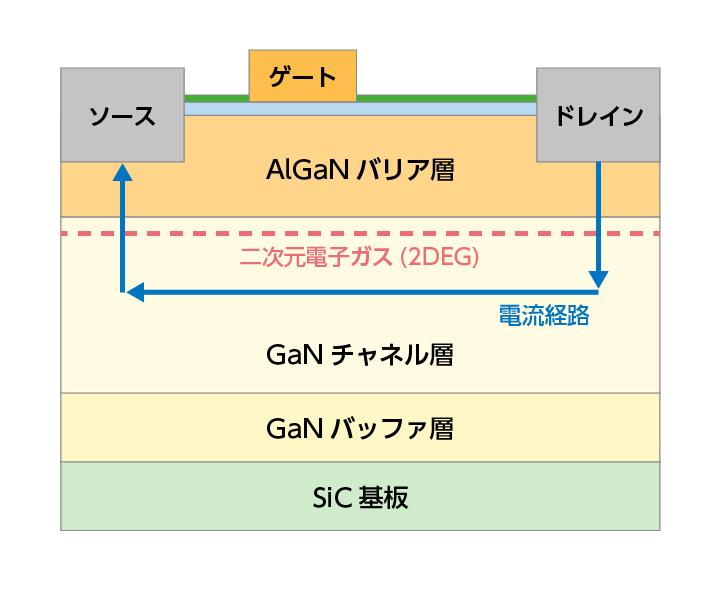
現在普及している高周波用GaN-HEMTの構造では、シリコンカーバイド(SiC)基板上にGaN結晶を成長させ、その上に窒化アルミニウムガリウム(AlGaN)を成長させてヘテロ接合を形成することで、界面に高移動度な二次元電子ガス(2DEG)を形成します。より高周波・高出力なGaN-HEMTの開発に向けた次世代バリア層として、高い電子発生能力を有する窒化スカンジウムアルミニウム(ScAlN)が注目されています。
これまで、ScAlNとGaNのヘテロ接合では、電子が高密度に集まるものの、その移動度が低く、移動度を制限する要因が理解されていないことが課題とされていました。今回の研究では、その移動度が主に界面ラフネス散乱*2によって制限されていることが明らかになりました。
■共同研究の役割
当社:研究に使用する高品質なGaN/SiC基板の提供
東京大学:GaN/SiC基板上へのScAlN/GaNヘテロ接合作製、測定・解析
本研究の成果は、窒化物半導体分野で最大規模の国際会議であるInternational Conference on Nitride Semiconductors (ICNS)において高い評価を受け、招待講演に選出されました。
今後は、界面ラフネスを改善し、高密度・高移動度の二次元電子ガスの形成を実現することで、次世代高周波通信に用いられるGaN-HEMTの性能向上に貢献し、当社製GaN-HMETへの適用も実現したいと考えています。
詳細は、東京大学のプレスリリースをご確認ください。
*1 ヘテロ接合:
異なる半導体材料の組み合わせによって形成される接合部分のこと。
*2 界面ラフネス散乱:
ヘテロ接合界面における凹凸が、電子の移動を阻害している現象のこと。
